釬鋅礦結構是由兩種具有負電性差的元素(如Ga, N)構成四面體,每個原子與周圍四個原子成鍵,沿六方對稱軸方向的鍵長要大于另外三個方向的鍵長,導致正負電荷中心不在同一點上,從而產生自發(fā)極化效應。如圖1左所示,具有(0001)方向(In,Al,Ga)N,4個電負性N原子構成四面體的中心在對稱軸(In,Al,Ga)原子上方,或者說,極化矢量P2在軸上方向分量之和小于P1,所以總自發(fā)極化方向為N原子中心指向III族原子,即(000-1)方向。而當受到壓應力時,如圖1中所示,四面體夾角變小,極化矢量P2在軸上方向分量增大,產生(0001)方向壓電極化;反之,當受到張應力時,如圖1右所示,四面體夾角變大,極化矢量P2在軸上方向分量減小,產生(000-1)方向極化。氮化物自發(fā)極化和受到壓應力、張應力壓電極化場示意圖如圖2所示。需要注意,極化矢量和極化電場方向相反。

圖1(0001)晶面氮化物自發(fā)極化(左)、壓應力(中)和張應力(右)下極化矢量球棍圖:總自發(fā)極化方向為(000-1),壓/張應力電極化方向為(0001)和(000-1)
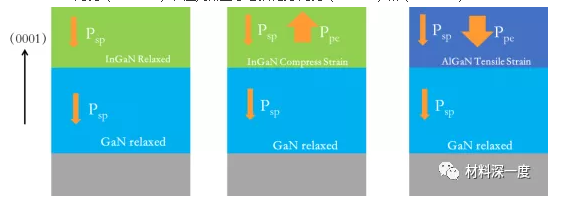
圖2 氮化物自發(fā)極化和受到壓應力、張應力壓電極化場示意圖
極化效應,包括自發(fā)極化和壓電極化,是第三代半導體GaN器件需要注意的重要因素。
一、光電子器件:GaN基LED和InGaN基太陽能電池
GaN基LED的有源區(qū)由InGaN/GaN多量子阱組成,其中發(fā)光波長由量子阱InGaN的In組份和阱寬度決定。由于In原子的晶格常數(shù)較Ga原子大,InGaN受到壓應力,產生(000-1)方向的壓電電場,即由p-GaN指向n-GaN,與LED中內建電場方向相反。壓電電場強度遠大于內建電場,使InGaN量子阱能帶發(fā)生陡峭傾斜,電子和空穴空間上被拉開一定距離,波函數(shù)重疊積分減小,從而降低輻射復合效率(圖3左)。對于InGaN基太陽能電池,將產生同樣和內建電場方向相反的壓電場,阻礙光生載流子的收集(圖3右)。壓電極化嚴重制約著LED和太陽能電池效率的提高。
研發(fā)人員通過設計很多新型的InGaN/GaN多量子阱結構來降低壓電極化對GaN基LED影響,如三角形量子阱、壘阱In組分漸變結構(Appl. Phys. Lett.105, 033506 (2014))、極化場補償結構(Appl. Phys. Lett.104, 243501 (2014))等。此外研究人員嘗試在壓電極化效應小的非極性面,和半極性面(如(11-22)GaN材料的生長。同樣,一些復合InGaN吸收層結構((Appl. Phys. Lett.96, 051107,(2010))或調制摻雜(Appl. Phys. Lett.98, 243507, 2011)用以屏蔽極化電荷,抑制壓電極化效應的不利影響。當然InGaN基太陽能電池還面臨高質量高In組分InGaN吸收層的外延生長等關鍵問題,而隨著In組分的提高,壓電極化效應影響將更加嚴重。而在GaN基LED和紫外LED中,壓電極化工程也被用以提高空穴的濃度和運動遷移速度(Science 01 Jan 2010: Vol. 327, Issue 5961, pp. 60-64,Appl. Phys. Lett., 105, 153503 (2014)等)。
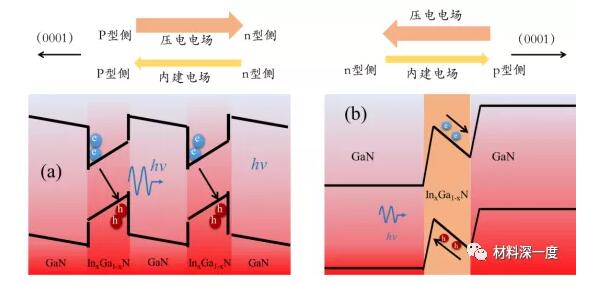
圖3 GaN基LED和InGaN基太陽能電池壓電效應影響能帶示意圖:壓電電場強度很大,方向為(000-1),同內建電場方向相反
二、電子器件:GaN基HEMT,TFET和隧穿二極管
與GaN基LED和InGaN基太陽能電池中壓電極化的負面影響不同,壓電極化是GaN基HEMT(High Electron Mobility Transistor,高電子遷移率晶體管)器件的原理基礎。如圖2右所示,在GaN緩存層上外延生長一定厚度AxGa1-xN層,由于AxGa1-xN的晶格常數(shù)小于GaN,所以AxGa1-xN層將受到張應力作用。由于壓電極化效應,異質結界面處的凈極化電荷為正,而且面密度極高。高密度的正極化電荷產生的強電場將使異質結邊界上的能帶產生很強突變,形成窄而深的電子勢阱。同時該強電場將會吸引材料中其他地方的自由電子被限制在厚度只有幾納米電子勢阱中,在與異質結界面平行的平面內運動,此二維溝道被稱為二維電子氣(2DEG)。隧穿場效應晶體管(TFETs, Tunnel field-effect transistors)通過柵極電壓的變化控制帶間隧穿電流,被看做是非常有前景的低工作電壓和低功耗的邏輯CMOS器件,其Ion和Ion/Ioff都會大于傳統(tǒng)MOSFTE,其S可以突破60mV/decade的限制,而且TFET的Ioff非常低,所以TFET的工作電壓可以進一步地降低。窄禁帶半導體(InGaAs, InAs和GaSb)TFETs已有實驗報道,雖然具有較高Ion,但Ioff同樣較高。寬禁帶半導體理論上可以具有很小Ioff,但是隧穿概率卻因寬禁帶的屬性而較小。如對于GaN同質結,即使n,p側均摻雜到3*10?/cm?量級,隧穿寬度仍然很大,達15nm,導致隧穿電流,即Ion會較小。利用極化效應的極化工程派上用場,利用強大的極化電場極大縮減隧穿距離,如 InN插入層,或者更加精細復雜的In組分漸變多InGaN層,見圖4所示。更多詳情可見, University of Notre Dame的PATRICK FAY的文章(Li et al.: Polarization-Engineered III-Nitride Heterojunction TFETs)。壓電極化效應也被用以制作二端隧穿二極管,可參考Appl. Phys. Lett., 107, 163504 (2015)等,制作三端二維空穴氣器件(A polarization-induced 2D hole gas in undoped gallium nitride quantum wells)。
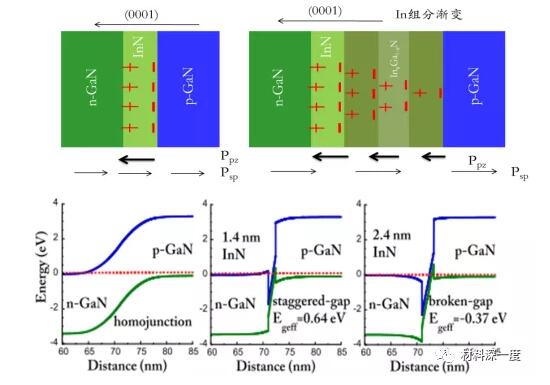
圖4 GaN基隧穿二極管示意圖:通過 InN插入層,或者更加精細復雜的In組分漸變多InGaN層等極化工程,可以增加隧穿概率
三、ZnO/GaN壓電MEMS器件
在壓電MEMS器件方面做到幾乎登峰造極的就是鼎鼎大名的王中林院士了。博士期間聽王中林院士應王占國院士邀請到半導體所做過一場學術報告。報告精彩帥氣,行云流水,聲情并舉,圖文并茂。至今十余年過去,至今印象深刻。王中林院士最開始從事電子顯微學研究(也是這個領域的世界頂級科學家),后來一直堅持從事基于壓電和摩擦式納米發(fā)電機和壓電電子學應用基礎、功能器件及集成系統(tǒng)研究。王中林院士著作等身,Nature,Science等頂級期刊手到擒來,學術論文被引用總數(shù)20萬次以上(google),并且壓電應用從最開始的ZnO材料,拓展到GaN材料、鋯鈦酸鉛等(PZT)及MoS2等同具壓電極化效應的二維材料等。
介紹下王中林院士的納米發(fā)電機鼎定江湖之作(SCIENCE VOL 312 14 APRIL 2006, 242-246),如圖5所示:ZnO納米線正常狀態(tài)無應力(A),AFM撥動使其受到拉應力(外側)和壓應力(內側),分別產生壓電電勢Vs—和Vs+(C,D);ZnO納米線底部與Ag電極形成歐姆接觸,ZnO納米線頂部與高功函數(shù)AFM針尖Pt金屬形成肖特基結;在針尖Pt和ZnO納米線頂部外側接觸時,Pt/ZnO肖特基結反偏,無電流通過(E);而當針尖Pt和ZnO納米線頂部內側接觸時,肖特基結正偏,形成正向電流,電子從n型ZnO納米線流向針尖Pt,中和固定壓電電荷直至達到平衡(F)。而用VLS法生長ZnO納米線頂部存留有較大尺寸Au顆粒時,短路效應將不會產生電流(I)。
另一個印象比較深的工作為p-GaN/n-ZnO納米線陣列的壓力傳感器(Nature Photonics, DOI: 10.1038/NPHOTON.2013.191)。基于第三代半導體納米線的壓電電子和光電子器件更多可以參考Chemical Review上的綜述文章(Chem. Rev. 2019, 119, 15, 9303–9359)。

圖5 ZnO納米線納米發(fā)電機原理:壓電效應產生正負電勢,使Pt-ZnO肖特基結正偏,電子從n型ZnO納米線流向針尖Pt,中和固定壓電電荷直至達到平衡
(圖片來自SCIENCE VOL 312 14 APRIL 2006, 242-246)
四、總結
壓電極化效應制約GaN基LED和太陽能電池效率的提高,卻是GaN基HEMT器件和ZnO/GaN壓電MEMS器件的物理基礎和根本。極化效應真是特別讓GaN材料和器件研究者“又有喜 又有愁”。
但是“大愛”的研究人員付出“柔情萬種”,利用壓電極化效應精巧設計“極化工程”結構,提升器件性能,包括突破壓電極化效應對LED和太陽能電池效率的制約、提高p-GaN空穴濃度、提升空穴的遷移速率、產生二維空穴氣制作HHMT、以及提高隧穿概率制作TFET和隧穿二極管器件等。而基于ZnO/GaN壓電效應的MEMS器件、能源器件等也越來越吸引更廣泛的興趣甚至應用。
作者簡介
汪煉成,物理電子學博士,中南大學特聘教授,博士生導師,微電子科學與工程系副主任,高性能復雜制造國家重點實驗室研究員。博士畢業(yè)于中科院半導體研究所, 先后在新加坡南洋理工大學,新加坡科技大學和英國謝菲爾德大學從事博士后研究工作,科研方向為第三代半導體電子/光電子器件和系統(tǒng)集成。
