氮化鎵(GaN)器件具有更高耐壓,更快的開關頻率,更小導通電阻等諸多優(yōu)異的特性,在功率電子器件領域有著廣泛的應用前景:從低功率段的消費電子領域,到中功率段的汽車電子領域,以及高功率段的工業(yè)電子領域。相比于橫向器件,GaN縱向功率器件能提供更高的功率密度、更好的動態(tài)特性、更佳的熱管理及更高的晶圓利用率,近些年已取得了重要的進展。而大尺寸、低成本的硅襯底GaN縱向功率器件更是吸引了國內外眾多科研團隊的目光。
中科院蘇州納米所孫錢研究團隊在讀博士研究生郭小路及其他團隊成員的合作攻關下,經過近三年時間的不懈努力,先后在高質量異質外延材料生長及摻雜精確調控、器件關態(tài)電子輸運機制及高壓擊穿機制、高性能離子注入保護環(huán)的終端開發(fā)等核心技術上取得突破,該系列研究工作先后發(fā)表于電子器件領域國際專業(yè)學術期刊IEEE Electron Device Letters, vol. 42, no. 4, pp. 473-476, Apr 2021. Applied Physics Letters, vol. 118, no. 24, 2021, Art. no. 243501. IEEE Transactions on Electron Devices, vol. 68, no. 11, pp. 5682-5686, 2021。
團隊成功研制出的高性能硅襯底GaN基垂直肖特基二極管,具有優(yōu)異的正向導通性能(Ron=1.0 mΩ·cm2),開關比高達1011,理想因子低至1.06,正向輸出電流1660A/cm2。器件的關態(tài)耐壓達603V,器件的Baliga優(yōu)值(衡量器件正反向電學性能的綜合指標)為0.26GW/cm2。器件在175oC的高溫及380V反向偏壓下,開關性能仍未發(fā)生失效,綜合實現了耐高溫、耐高壓等優(yōu)異特性。硅襯底GaN基縱向功率二極管器件性能目前處于國際前列。
上述系列工作的主要作者為中科院蘇州納米所在讀博士研究生郭小路,團隊特別研究助理鐘耀宗博士和已畢業(yè)博士生何俊蕾等為相關工作作出了重要貢獻,通訊作者為孫錢研究員和周宇副研究員。上述工作得到了國家自然科學重點基金項目、國家重點研發(fā)計劃課題、中國科學院重點前沿科學研究計劃、江蘇省重點研發(fā)計劃項目等資助。
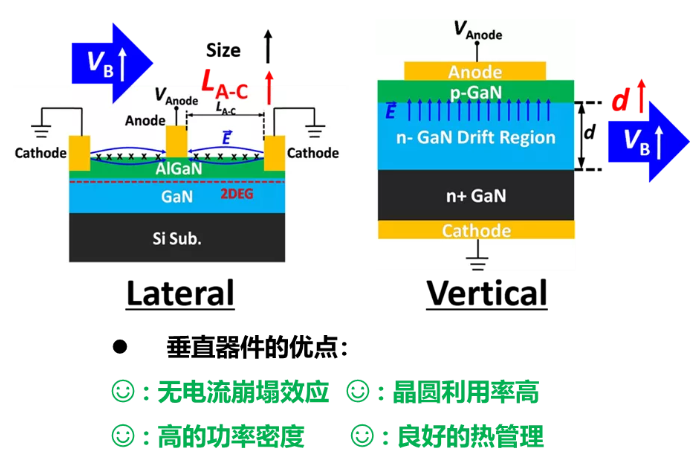
圖1. GaN 水平器件與垂直器件的特點比較

圖2. GaN基縱向功率二極管的關態(tài)擊穿電壓與開態(tài)導通電阻(Ron,sp)的評價體系。國內外相關研究團隊的自支撐襯底和硅襯底GaN基肖特基勢壘二極管(SBD),結勢壘肖特基二極管(JBS),凹槽MOS型肖特基二極管(TMBS)器件性能的比較。
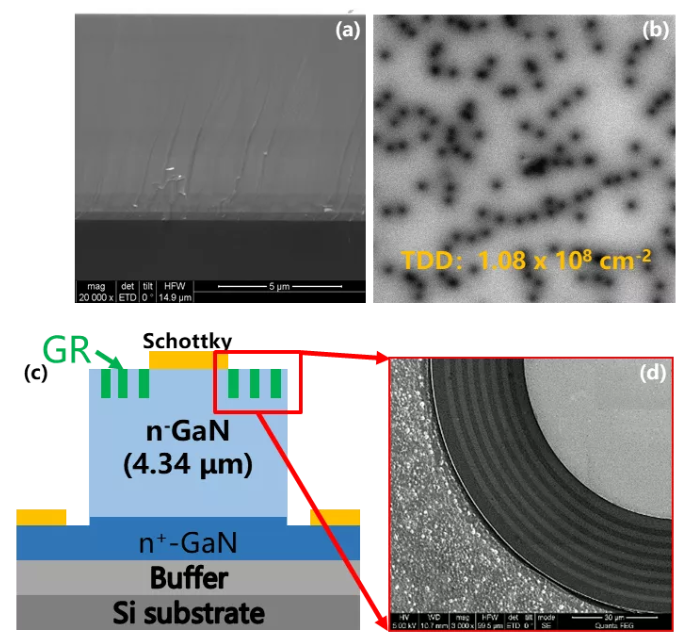
圖3.(a)硅基GaN縱向功率二極管的外延結構(b)外延材料的CLmapping(c)器件的結構示意圖(d)制備器件的離子注入保護環(huán)。
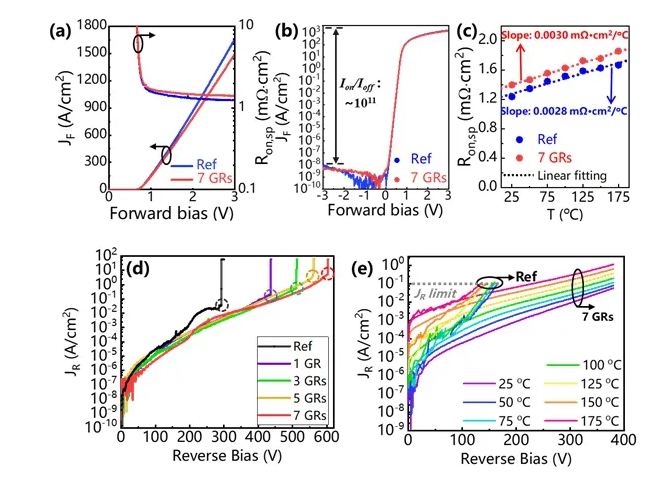
圖4.(a)線性坐標下與(b)對數坐標下有、無離子注入保護環(huán)(GR)終端的硅基GaN縱向SBD的正向IV曲線(c)不同溫度下硅基GaN縱向SBD的開態(tài)導通電阻(d)離子注入保護環(huán)個數對反向擊穿耐壓的影響。(e)有、無離子注入保護環(huán)對硅基GaN縱向SBD溫度特性的影響。
