近日,微電子所高頻高壓中心劉新宇研究員團(tuán)隊(duì)與先導(dǎo)中心工藝平臺合作,在GaN界面態(tài)研究領(lǐng)域取得了重大突破,在LPCVD-SiNx/GaN界面獲得原子級平整界面和國際先進(jìn)水平的界面態(tài)特性,提出了適用于較寬能量范圍的界面態(tài)U型分布函數(shù),實(shí)現(xiàn)了離散能級與界面態(tài)的分離。
增強(qiáng)型氮化鎵MIS-HEMT是目前尚未成功商用化的技術(shù)路線。GaN與介質(zhì)的界面態(tài)問題是制約器件可靠性的主要因素之一。
前期研究發(fā)現(xiàn),LPCVD-SiNx具有高溫耐受性、成膜質(zhì)量高、結(jié)構(gòu)致密、無離子損傷、高TDDB特性等優(yōu)勢,有望用于高可靠MIS-HEMT的柵介質(zhì)和鈍化材料。
然而,傳統(tǒng)LPCVD-SiNx的生長溫度較高,可能導(dǎo)致材料表面熱分解和熱反應(yīng),尤其是刻蝕表面。同時,高溫工藝(例如,800℃以上歐姆合金)會導(dǎo)致鈍化位的氫鍵被破壞,使介質(zhì)界面發(fā)生一定程度的退化,引起鍵長鍵角隨機(jī)變化的無序粗糙晶化區(qū)域和梯度變化的無定形區(qū)域產(chǎn)生,導(dǎo)致器件出現(xiàn)不可控制的頻率色散和滯回現(xiàn)象。
要避免上述不利因素,制備的健壯界面需具有原子級平整特性和最小退變的長程有序晶體區(qū)域。
另一方面,由于寬帶隙半導(dǎo)體中缺陷電子捕獲截面分布范圍較寬,超淺能級和深能級界面態(tài)都可能影響器件的頻率色散和電流崩塌。
因此,在更寬能量范圍內(nèi)評估界面態(tài)變得非常有意義。恒定電容深能級瞬態(tài)傅里葉光譜技術(shù)可實(shí)現(xiàn)10~400K溫度范圍內(nèi)的測試,為上述需求提供了有效的表征解決方案。
但多層材料中界面態(tài)和離散能級缺陷的檢測密度通常被耦合,使介質(zhì)/ III-N界面的缺陷分析更加復(fù)雜,需要利用界面態(tài)分布函數(shù)分離界面態(tài)和離散缺陷能級。雖然基于DIGS理論的U型模型適合連續(xù)能級的界面態(tài)分布,但在較寬的能量范圍上仍然有一些限制。
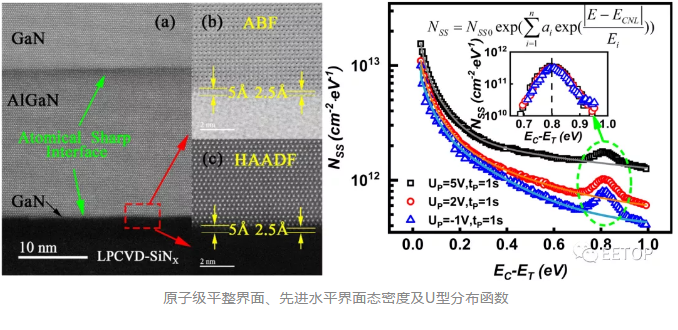
本工作證明了低熱預(yù)算工藝是實(shí)現(xiàn)高質(zhì)量界面的有效手段之一,包括:LPCVD-SiNx 生長溫度從常規(guī)780℃降低到650℃,歐姆合金溫度從850度降低到780℃。工作難點(diǎn)在于降低溫度窗口且保證高質(zhì)量薄膜和歐姆接觸。
最終在LPCVD-SiNx和GaN之間實(shí)現(xiàn)2.5-5埃米原子級平整界面,界面態(tài)密度在ET=30 meV下約1.5×1013 cm-2eV-1,ET=1 eV下約4×1011~1.2×1012 cm-2eV-1水平。
團(tuán)隊(duì)創(chuàng)新性提出了適用于較寬能量范圍的基于物理參數(shù)的界面態(tài)U型分布函數(shù),實(shí)現(xiàn)了多層材料中離散能級與界面態(tài)的有效分離。該成果以“Suppression and characterization of interface states at low-pressure-chemical-vapor-deposited SiNx/III-nitride heterostructures”為題發(fā)表在Applied Surface Science期刊上。(DOI:10.1016/j.apsusc.2020.148530 )。
本工作得到了國家自然科學(xué)基金重大儀器項(xiàng)目、重點(diǎn)項(xiàng)目、面上項(xiàng)目和中科院前沿重點(diǎn)項(xiàng)目等資助。
相關(guān)論文連接:
https://www.sciencedirect.com/science/article/abs/pii/S0169433220332888
