“先進封裝”是半導(dǎo)體產(chǎn)業(yè)近年來的熱詞之一,也掀起了封裝技術(shù)發(fā)展史上的第三次技術(shù)躍進。有人對它有一個形象比喻“攤大餅不行了,做一下千層餅試試吧”。 為什么這么說?以2.5D、3D封裝為代表的、結(jié)合了芯片堆疊和異構(gòu)封裝等技術(shù)的先進封裝,正在為摩爾定律指揮棒下的芯片實現(xiàn)爭取更優(yōu)方案。對話英特爾院士/封裝研究與系統(tǒng)解決方案總監(jiān)Johanna Swan,就先進封裝的關(guān)鍵技術(shù)、發(fā)展方向等問題進行了深入交流。


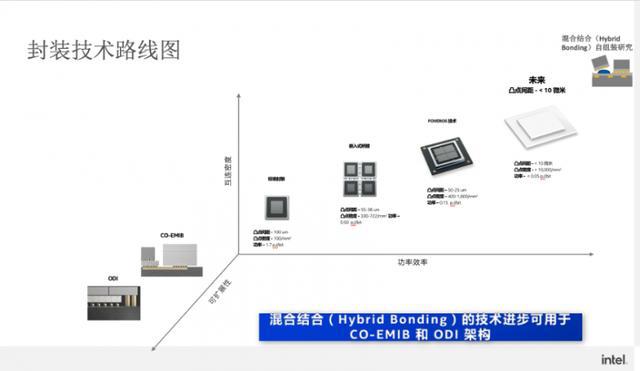


為什么需要先進封裝?
多年來,業(yè)界并沒有在先進封裝上投入太多精力,但近年來情況發(fā)生了變化。Johanna Swan指出,由于先進封裝技術(shù)能夠集成多種制程工藝的計算引擎,實現(xiàn)類似于單晶片的性能,但其平臺范圍遠遠超過單晶片集成的晶片尺寸限制。這些技術(shù)將大大提高產(chǎn)品級性能和功效,縮小面積,同時對系統(tǒng)架構(gòu)進行全面改造。正因如此,先進封裝成為各公司打造差異化優(yōu)勢的一個重要領(lǐng)域,以及提升性能、提高功率、縮小外形尺寸和提高帶寬的機會。
從Intel 的先進封裝技術(shù)路線圖可以看出,三大維度是未來方向:X軸代表功率效率,Y軸代表互連密度,Z軸代表可擴展性。

多區(qū)塊異構(gòu)集成提升功率效率
Johanna Swan介紹,單獨IP的異構(gòu)集成能夠帶來更大量的更小區(qū)塊,它們可以大量重復(fù)使用,開發(fā)時間從單片式集成SoC的3-4年、多晶片2-3年縮短至1年,并且芯片缺陷率進一步降低。這樣一來,便于根據(jù)客戶的獨特需求定制產(chǎn)品,滿足產(chǎn)品快速的上市需求。
多區(qū)塊異構(gòu)集成能夠解決芯片設(shè)計和制造的諸多限制,但與此同時,它所帶來的影響也是深遠的,主要體現(xiàn)在兩方面:一是晶片間互連的微縮從焊接轉(zhuǎn)到混合結(jié)合(Hybrid Bonding),二是大量區(qū)塊轉(zhuǎn)變到按批次組裝的精確放置,這樣又帶來了新的挑戰(zhàn)。

大量區(qū)塊如何保持制造流程以相同的速度進行?有更多的晶片需要放置,能否在一次只放置一個晶片的基礎(chǔ)上加快速度?英特爾正在考慮的解決方案是批量組裝/自組裝。
目前,英特爾正在與法國原子能委員會電子與信息技術(shù)實驗室(CEA-LETI)合作,研究一次放置多個晶片,進行確定性對齊,并使用超小的晶片,進行快速放置,通過批次組裝,實現(xiàn)拾取更多、并放置更多晶片。Johanna Swan通過一個視頻介紹了自組裝的大概機制:把晶片放在一個能夠?qū)⒆陨砘謴?fù)到最低能量狀態(tài)的位置,這時就不需要設(shè)備,只需要讓它足夠接近、試圖達到最低限度的能量狀態(tài)時,就會自己組裝、放置到位。在英特爾的封裝技術(shù)路線圖中,最新增加了混合結(jié)合自組裝研究為未來的方向。
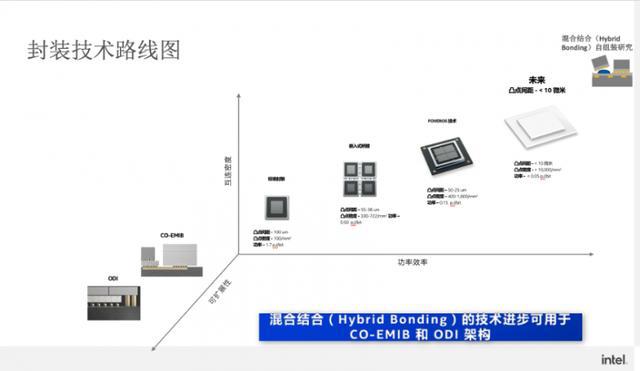
為異構(gòu)計算而生的混合結(jié)合技術(shù)
在英特爾的封裝技術(shù)路線中,混合結(jié)合是一種在相互堆疊的芯片間獲得更密集互連的方法,并且能夠幫助實現(xiàn)更小的外形尺寸。
當(dāng)前的Foveros技術(shù)能實現(xiàn)的是凸點間距 50 微米,這將使每平方毫米有大約 400 個凸點。 由于面積隨著凸點間距在微縮,未來,英特爾希望能縮減到大約 10 微米的凸點間距,達到每平方毫米 10000 個凸點。 這樣,就可以實現(xiàn)更小、更簡單的電路,更低的電容和功耗,實際上可以進行相互疊加,不必做扇入(fan-in)和扇出(fan-out)。

Johanna Swan表示,混合結(jié)合可以說是為異構(gòu)計算而生的,主要有兩大原因:第一,大多數(shù)封裝技術(shù)中使用的是傳統(tǒng)的“熱壓結(jié)合(thermocompression bonding)”技術(shù),而混合結(jié)合技術(shù)是這一技術(shù)的替代品。這項新技術(shù)能夠加速實現(xiàn)10微米及以下的凸點間距,提供更高的互連密度、帶寬和更低的功率。
第二,先進的處理系統(tǒng)需要高帶寬和子系統(tǒng)(處理器、片上網(wǎng)絡(luò)和處理元件)之間的低功耗互連。傳統(tǒng)上,這些子系統(tǒng)都是單片集成在一個芯片上。隨著異構(gòu)集成技術(shù)的發(fā)展,單片集成已經(jīng)不再適用。擴大芯片之間的互連間距對于異構(gòu)計算的發(fā)展非常重要,而混合結(jié)合技術(shù)就是解決這一問題的重要技術(shù)之一。
混合結(jié)合技術(shù)已經(jīng)應(yīng)用于諸如像圖像傳感器和非易失性存儲器等應(yīng)用,目前,它的商業(yè)應(yīng)用還局限于晶圓與晶圓之間的結(jié)合,并且只能在低能耗的系統(tǒng)中。未來,混合結(jié)合會擴展到晶片與晶圓的應(yīng)用中,以支持計算chiplet、內(nèi)存chiplet的靈活異構(gòu)集成,以及未來更高能耗的系統(tǒng)中。
Johanna Swan強調(diào),定制將是下一階段異構(gòu)集成的重要驅(qū)動力。通過將更多不同的節(jié)點或 IP 組合,在不同的制程或節(jié)點上進行集成,通過這種混合搭配,可以為特定客戶進行深度定制。
可擴展性是先進封裝的重要維度
可擴展性是英特爾先進封裝路線的又一個維度,在這個維度上,ODI和CO-EMIB是兩大關(guān)鍵技術(shù)。
英特爾構(gòu)建高密度MCP的關(guān)鍵基礎(chǔ)技術(shù)包括EMIB、Foveros和Co-EMIB。其中,EMIB(嵌入式多芯片互連橋接)2D封裝和Foveros 3D封裝技術(shù)利用高密度的互連技術(shù),能夠?qū)崿F(xiàn)高帶寬、低功耗,并實現(xiàn)相當(dāng)有競爭力的I/O密度。Co-EMIB則融合了2D和3D,將更高的計算性能和能力連接起來,基本達到單晶片性能。

FOVEROS技術(shù)前文已提到過,它作為當(dāng)前的混合結(jié)合技術(shù)方式,能夠為密度更高的垂直互連實現(xiàn)更小的尺寸。
那么,ODI又是什么技術(shù)呢?它是英特爾全新的全方位的互連技術(shù),能夠為封裝中小芯片之間的全方位互連通信提供靈活性。頂部芯片可以像EMIB技術(shù)下與其他小芯片進行水平通信;同時還可以像Foveros技術(shù)下,通過硅通孔(TSV)與下面的底部裸片進行垂直通信。這種方法減少了基底晶片中所需的硅通孔數(shù)量,為有源晶體管釋放了更多的面積,并優(yōu)化了裸片的尺寸。
極致的異構(gòu)集成是半導(dǎo)體封裝未來趨勢
談到先進封裝,小芯片Chiplet是一個必須要探討的話題。Johanna Swan認為,小芯片最重要的事情是它能夠幫助我們獲得越來越小的IP。一旦擁有較小的 IP,它就可以混合在眾多產(chǎn)品中,這可以具有非常高的重用水平,可以根據(jù)放入封裝中的產(chǎn)品進行深度定制。
而定制將是實現(xiàn)下一階段異構(gòu)集成的驅(qū)動力,通過將更多不同的節(jié)點或 IP 組合,在不同的制程或節(jié)點上進行集成, 通過這種混合搭配,可以為特定客戶進行深度定制。
她強調(diào),極致的異構(gòu)集成是方向,也是封裝技術(shù)的未來趨勢。封裝技術(shù)將繼續(xù)具有縮小尺寸的特征,能夠?qū)⒃絹碓叫〉?IP 和越來越小的區(qū)塊集合在一起。歸根結(jié)底,我們擁有的發(fā)展機會是在每毫米立方體上提供最多的區(qū)塊并獲得每毫米立方體最多的功能,所以我們還沒有走到極限。封裝將繼續(xù)小型化和縮小尺寸,以便獲取有限體積內(nèi)的最大功能。
