碳化硅作為一種寬禁帶材料, 具有高擊穿場強、高飽和電子漂移速率、高熱導(dǎo)率等優(yōu)點,可以實現(xiàn)高壓、大功率、高頻、高溫應(yīng)用的新型功率半導(dǎo)體器件。該文對碳化硅功率半導(dǎo)體器件的最新發(fā)展進行回顧,包括碳化硅功率二極管、MOSFET、IGBT,并對其在電力系統(tǒng)的應(yīng)用現(xiàn)狀與前景進行展望。
1 引言
理想的半導(dǎo)體功率器件, 應(yīng)當(dāng)具有這樣的靜態(tài)和動態(tài)特性:在阻斷狀態(tài), 能承受高電壓;在導(dǎo)通狀態(tài), 具有高的電流密度和低的導(dǎo)通壓降;在開關(guān)狀態(tài)和轉(zhuǎn)換時,具有短的開、關(guān)時間,能承受高的di /d t 和du/d t ,具有低的開關(guān)損耗,并具有全控功能。半個多世紀以來(自 20世紀50年代硅晶閘管的問世),半導(dǎo)體功率器件的研究工作者為實現(xiàn)上述理想的器件做出了不懈的努力,并已取得了世人矚目的成就。各類硅基功率半導(dǎo)體器件 (功率二極管、 VDMOS、IGBT、IGCT等)被成功制造和應(yīng)用, 促使各種新型大功率裝置成功地應(yīng)用于各種工業(yè)電源、電機驅(qū)動、電力牽引、電能質(zhì)量控制、可再生能源發(fā)電、分布式發(fā)電、國防和前沿科學(xué)技術(shù)等領(lǐng)域。
然而由于在電壓、 功率耐量等方面的限制, 這些硅基大功率器件在現(xiàn)代高性能電力電子裝置中(要求具有變流、變頻和調(diào)相能力;快速的響應(yīng)性能~ms;利用極小的功率控制極大功率;變流器體積小、重量輕等)不得不采用器件串、并聯(lián)技術(shù)和復(fù)雜的電路拓撲來達到實際應(yīng)用的要求,導(dǎo)致裝置的故障率和成本大大增加,制約了現(xiàn)代電力系統(tǒng)的進一步發(fā)展。
近年來,作為新型的寬禁帶半導(dǎo)體材料——碳化硅(SiC),因其出色的物理及電特性, 正越來越受到產(chǎn)業(yè)界的廣泛關(guān)注。碳化硅功率器件的重要優(yōu)勢在于具有高壓 ( 達數(shù)萬伏 ) 、高溫 ( 大于500℃) 特性,突破了硅基功率器件電壓( 數(shù)kV)和溫度 ( 小于150℃) 限制所導(dǎo)致的嚴重系統(tǒng)局限性。隨著碳化硅材料技術(shù)的進步,各種碳化硅功率器件被研發(fā)出來,如碳化硅功率二極管、MOSFET、IGBT等,由于受成本、產(chǎn)量以及可靠性的影響, 碳化硅功率器件率先在低壓領(lǐng)域?qū)崿F(xiàn)了產(chǎn)業(yè)化,目前的商業(yè)產(chǎn)品電壓等級在 600~1700V。近兩年來,隨著技術(shù)的進步,高壓碳化硅器件 已經(jīng) 問世 ,如 19.5kV 的碳 化硅 二極 管 [1] , 10kV的 碳化 硅MOSFET[2] 和13~15kV[3-4] 碳化硅 IGBT等,并持續(xù)在替代傳統(tǒng)硅基功率器件的道路上取得進步。這些碳化硅功率器件的成功研發(fā)帶來了半導(dǎo)體功率器件性能的飛躍提升,引發(fā)了新一輪技術(shù)革命, 必將在眾多應(yīng)用領(lǐng)域, 如電力系統(tǒng)中的高壓領(lǐng)域產(chǎn)生深遠的影響。
2 碳化硅材料及功率器件進展
2.1 碳化硅材料
在體單晶材料方面, SiC單晶襯底已經(jīng)商品化。目前國際上已有76.2 mm和101.6 mm的SiC拋光襯底材料出售,具有批量生產(chǎn)能力的公司超過十家。高功率SiC器件的芯片面積很大 ( 單胞面積 > 1cm),需要大尺寸和低缺陷的襯底材料,尤其需要很低的微管缺陷密度。在這種需要的激勵之下并經(jīng)過長期的技術(shù)積累,困擾SiC單晶生長的微管缺陷控制技術(shù)也在 2004年獲得突破。如日本 Toyata公司采用“重復(fù) a面”(repeated a-face :RAF)生長技術(shù),實現(xiàn)了 50.8mm SiC單晶的無微管生長,同時也將位錯密度降低到250/cm2以下[5]。2005年美國 Intrinsic公司也獲得了零微管 (Zero Micropipe ,簡稱ZMP)的SiC單晶技術(shù),并于 2006年生長出無微管的 76.2 mm SiC襯底材料。在并購了 Intrinsic公司獲得零微管技術(shù)后, Cree公司直徑 101.6 mm的4H-SiC導(dǎo)通襯底的微管密度最低達 0.1/cm2,甚至零微管,使得用于制作面積為1cm2的功率器件能夠?qū)崿F(xiàn) 90%以上的器件成品率。外延材料方面,SiC外延生長設(shè)備的規(guī)模也不斷增大,能夠同時生長多片大尺寸的 SiC外延。例如瑞典 Epigress 公司的 VP2800HW型熱壁式 SiC外延生長系統(tǒng)能夠同時生長 10片101.6 mm高質(zhì)量 SiC外延,為了把 SiC功率器件抵抗電壓提高到 10kV,SiC外延的厚度要達到 100μ m。在SiC外延研究中,一個重要指標是外延層少子壽命。少子壽命不僅反映了深能級密度和材料缺陷密度等重要外延參數(shù),而且直接決定了高功率 SiC器件的通流能力。據(jù)理論研究,20kV SiC器件中少子壽命應(yīng)在 10s以上,否則通流能力很弱。
目前日本NEDO公司利用垂直型外延爐實現(xiàn)了高質(zhì)量的厚達 28μm的外延,在 50.8 mm上取得了少子壽命分布圖,其平均值為1s[6] 。SiC外延技術(shù)研究的另一個重要問題是 4°偏軸 4H-SiC襯底上的高質(zhì)量外延生長。4°偏軸襯底憑借其成本優(yōu)勢逐漸成為大尺寸4H-SiC的主流,但與8°偏軸相比小角度偏軸襯底上外延生長的難度較高,臺階聚并(step-bunching) 現(xiàn)象嚴重,導(dǎo)致出現(xiàn)表面形貌差、 缺陷密度高以及外延材料均勻性不好等問題。美國Cree公司通過改進生長條件和生長步驟獲得了101.6 mm 4°偏軸 4H-SiC襯底上理想的外延生長工藝,缺陷密度只有 2/cm2。這些外延材料參數(shù)可滿足 SiC器件研究和批量生產(chǎn)的要求 [7] 。
2.2 碳化硅功率二極管
碳化硅功率二極管有 3種類型:肖特基二極管(Schottky barrier diode ,SBD)、PIN 二極管和結(jié)勢壘控制肖特基二極管(junction barrier Schottky,JBS)。在5kV阻斷電壓以下的范圍, 碳化硅結(jié)勢壘肖特基二極管是較好的選擇。JBS二極管結(jié)合了肖特基二極管所擁有的出色的開關(guān)特性和PIN結(jié)二極管所擁有的低漏電流的特點。把 JBS二極管結(jié)構(gòu)參數(shù)和制造工藝稍作調(diào)整就可以形成混合PIN-肖特基結(jié)二極管 (merged PIN Schottky ,MPS)。由于碳化硅二極管基本工作在單極型狀態(tài)下,反向恢復(fù)電荷量基本為零, 可以大幅度地減少二極管反向恢復(fù)引起的自身瞬態(tài)損耗以及相關(guān)的 IGBT 開通瞬態(tài)損耗,非常適用于開關(guān)頻率較高的電路。
PIN結(jié)二極管在 4~5kV或者以上的電壓時具有優(yōu)勢, 由于其內(nèi)部的電導(dǎo)調(diào)制作用而呈現(xiàn)出較低的導(dǎo)通電阻, 使得它比較適用于高電壓應(yīng)用場合。有文獻報道阻斷電壓為 14.9和19.5kV的超高壓 PIN二極管,其正向和反向?qū)ㄌ匦匀鐖D1所示,在電流密度為 100 A/cm2時,其正向壓降分別僅為 4.4 和6.5V[1] 。這種高壓的 PIN二極管在電力系統(tǒng),特別是高壓直流輸電領(lǐng)域具有潛在的應(yīng)用價值。
2.3 碳化硅 MOSFET器件
功率MOSFET具有理想的柵極絕緣特性、 高速的開關(guān)性能、 低導(dǎo)通電阻和高穩(wěn)定性,在硅基器件中,功率 MOSFET獲得巨大成功。同樣,碳化硅 MOSFE也是最受矚目的碳化硅功率開關(guān)器件, 其最明顯的優(yōu)點是, 驅(qū)動電路非常簡單及與現(xiàn)有的功率器件 ( 硅功率 MOSFET和IGBT)驅(qū)動電路的兼容性。碳化硅功率 MOSFET面臨的兩個主要挑戰(zhàn)是柵氧層的長期可靠性問題和溝道電阻問題。

圖1 超高壓 SiC PIN 二極管
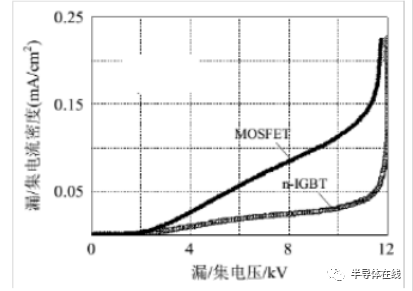
圖2 10kV SiC MOSFET與SiC IGBT正向阻斷特性
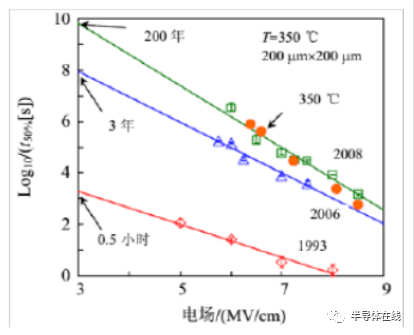
圖3 柵氧層可靠性的改進
隨著碳化硅 MOSFET 技術(shù)的進步,高性能的碳化硅 MOSFET也被研發(fā)出來,已有研究結(jié)果報道了具有較大的電壓電流能力的碳化硅MOSFET器件。三菱公司報道的1.2kV碳化硅 MOSFET器件的導(dǎo)通比電阻為 5mΩ·cm 2,比硅基的 CoolMOS的性能指數(shù)好 15~20倍。美國 Cree公司報道了 8.1mm×8.1mm、阻斷電壓 10 kV、電流 20 A的碳化硅 MOSFET芯片,其正向阻斷特性如圖 2所示。通過并聯(lián)這樣的芯片得到的模塊可以具備 100 A的電流傳輸能力 [3] 。該器件在 20 V的柵壓下的通態(tài)比電阻為127 mΩ·cm2,同時具有較好的高溫特性,在 200 ℃條件下,零柵壓時可以實現(xiàn)阻斷10 kV電壓。在碳化硅 MOSFET 的可靠性研究方面,有研究報道了在350 ℃下碳化硅柵氧層具有良好的可靠性 [8] 。如圖 3所示, 20 年以來碳化硅 MOSFET 柵氧層的可靠性得到明顯提高。這些研究結(jié)果表明,柵氧層將有望不再是碳化硅MOSFET 的一個瓶頸。
2.4 碳化硅 IGBT
在高壓領(lǐng)域,碳化硅 IGBT器件將具有明顯的優(yōu)勢。由于受到工藝技術(shù)的制約,碳化硅 IGBT的起步較晚,高壓碳化硅 IGBT面臨兩個挑戰(zhàn):第一個挑戰(zhàn)與碳化硅MOSFET器件相同,溝道缺陷導(dǎo)致的可靠性以及低電子遷移率問題;第二個挑戰(zhàn)是N型IGBT需要P型襯底,而 P 型襯底的電阻率比 N 型襯底的電阻率高 50倍。因此,1999 年制成的第一個 IGBT 采用了 P 型襯底。經(jīng)過多年的研發(fā), 逐步克服了 P 型襯底的電阻問題, 2008 年報道了 13 kV的N溝道碳化硅 IGBT器件,比導(dǎo)通電阻達到22mΩ·cm 2[3] 。圖4對15kV的N-IGBT和MOSFET 的正向?qū)芰ψ隽艘粋€比較 [4] ,結(jié)果顯示,在結(jié)溫為 300 K時,在芯片功耗密度為 200 W/cm2 以下的條件下,MOSFET可以獲得更大的電流密度, 而在更高的功耗密度條件下, IGBT可以獲得更大的電流密度。但是在結(jié)溫為 127℃時, IGBT在功耗密度為 50 W/cm2以上的條件下就能夠?qū)ū?MOSFET更高的電流密度。同一年,該團隊還報道了阻斷電壓達到12kV的P溝道碳化硅 IGBT,導(dǎo)通比電阻達到 14mΩ·cm 2[8] 。新型高溫高壓碳化硅IGBT器件將對大功率應(yīng)用, 特別是電力系統(tǒng)的應(yīng)用產(chǎn)生重大的影響。在15kV以上的應(yīng)用領(lǐng)域,碳化硅 IGBT綜合了功耗低和開關(guān)速度快的特點, 相對于碳化硅的 MOSFET以及硅基的 IGBT、晶閘管等器件具有顯著的技術(shù)優(yōu)勢, 特別適用于高壓電力系統(tǒng)應(yīng)用領(lǐng)域。
3 碳化硅功率器件在電力系統(tǒng)中的應(yīng)用展望
3.1 固態(tài)變壓器
隨著分布式發(fā)電系統(tǒng)、 智能電網(wǎng)技術(shù)以及可再生能源的發(fā)展, 固態(tài)變壓器作為其中的關(guān)鍵技術(shù)受到廣泛關(guān)注。固態(tài)變壓器是一種以電力電子技術(shù)為核心的變電裝置,它通過電力電子變流器和高頻變壓器實現(xiàn)電力系統(tǒng)中的電壓變換和能量傳遞及控制, 以取代電力系統(tǒng)中的傳統(tǒng)的工頻變壓器。與傳統(tǒng)變壓器相比, 具有體積小、重量輕等優(yōu)點, 同時具有傳統(tǒng)變壓器所不具備的諸多優(yōu)點,包括供電質(zhì)量高、功率因數(shù)高、自動限流、具備無功補償能力、頻率變換、輸出相數(shù)變換以及便于自動監(jiān)控等優(yōu)點。固態(tài)變壓器的輸入側(cè)電壓等級非常高, 一般在數(shù)千至數(shù)萬伏,目前多采用拓撲或器件串聯(lián)的方式, 結(jié)構(gòu)較為復(fù)雜。圖5所示為 10kVA的固態(tài)變壓器示意圖 [9]。新興的碳化硅電力電子器件, 特別是 15kV以上碳化硅 MOSFET、IGBT的出現(xiàn),將有利于固態(tài)變壓器的結(jié)構(gòu)簡化及可靠性提升。
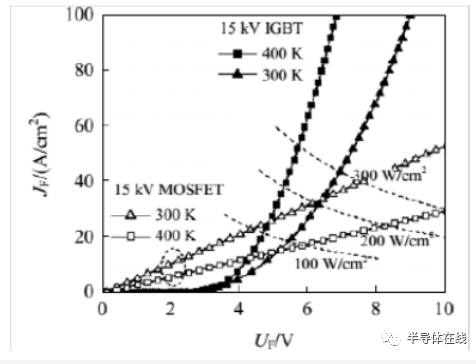
圖4 15kV SiC IGBT 和MOSFET導(dǎo)通特性對比
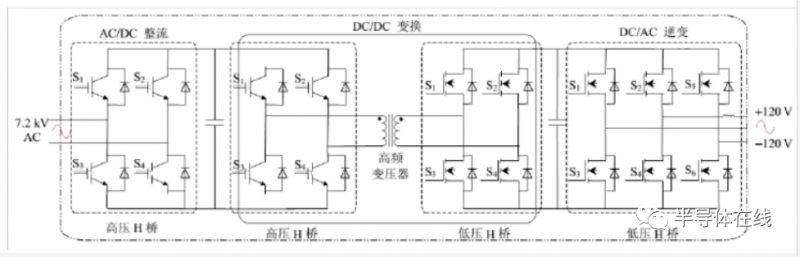
圖5 10kVA的固態(tài)變壓器示意圖
3.2 柔性交流輸電系統(tǒng)
柔性交流輸電系統(tǒng)( FACTS)是指電力電子技術(shù)與現(xiàn)代控制技術(shù)結(jié)合,以實現(xiàn)對交流輸電系統(tǒng)電壓、相位角、品質(zhì)、功率潮流的連續(xù)調(diào)節(jié)控制,從而大幅度提高輸電線路輸送能力和提高電力系統(tǒng)穩(wěn)定水平,降低輸電損耗。FACTS技術(shù)主要采用晶閘管、 GTO、IGBT等器件,由于硅器件自身物理限制,致使更高電壓等級或者更高功率等級的 FACTS控制器在實際應(yīng)用中受到制約。碳化硅功率器件固有的高耐壓特性,隨著其器件水平的不斷發(fā)展,在FACTS技術(shù)中必然越來越受到重視。
3.3 直流輸電技術(shù)
輕型直流輸電技術(shù)是在高壓直流輸電的基礎(chǔ)上發(fā)展起來的一項新技術(shù),其特點是直流輸電兩端變流器采用可關(guān)斷器件構(gòu)成電壓源逆變器,不存在換相失敗、受端系統(tǒng)必須提供無功容量的問題, 而且可以省去換流變壓器, 簡化換流站結(jié)構(gòu)。受制于可關(guān)斷硅器件水平的制約,其輸電容量通常較小。圖6是輕型直流輸電中
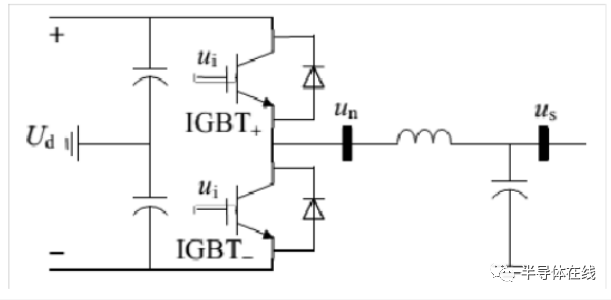
圖6 由IGBT構(gòu)成的電壓源型換流器單相圖
由IGBT構(gòu)成的電壓源型換流器 [10] ,利用脈寬調(diào)制 (pulse width modulation ,PWM)技術(shù)進行無源逆變, 不但可以向無交流電源的負荷點送電, 在特殊情況下也可以提供無功功率。隨著碳化硅 MOSFET/IGBT 等器件性能、 電壓等級和功率等級的提高, 碳化硅電力電子器件在輕型直流輸電系統(tǒng)中的應(yīng)用, 有望進一步提高其輸電容量及適用電壓等級,為輕型直流輸電的應(yīng)用拓展帶來新的機遇。
4 總結(jié)
在當(dāng)前節(jié)能減排的重大國際發(fā)展趨勢下, 對于碳化硅功率器件而言, 其優(yōu)勢明顯??梢灶A(yù)見,新型高壓大容量碳化硅功率器件將在高壓電力系統(tǒng)中開辟出全新的應(yīng)用,對電力系統(tǒng)的發(fā)展和變革產(chǎn)生持續(xù)的重大影響。
