生長SiC單晶的方法主要有:物理氣相傳輸法(physical vapor transport, PVT)、高溫化學氣相沉積(high temperature chemical vapor deposition, HTCVD)法和高溫溶液生長(high temperature solution growth, HTSG)法。如圖1所示。其中,PVT法是現(xiàn)階段發(fā)展最成熟、應(yīng)用最廣泛的方法,目前已實現(xiàn)6英寸單晶襯底產(chǎn)業(yè)化,8英寸單晶也已在2016年由美國Cree公司生長成功。但該方法存在缺陷密度較高、成品率低、擴徑困難、成本高等局限。
HTCVD法是利用Si源和C源氣體在2100 ℃左右的高溫環(huán)境下發(fā)生化學反應(yīng)生成SiC的原理來實現(xiàn)SiC單晶的生長,與PVT法一樣,該方法也需要高生長溫度,且生長成本高。HTSG法不同于上述兩種方法,其基本原理是利用Si和C元素在高溫溶液中的溶解、再析出來實現(xiàn)SiC單晶的生長,目前廣泛采用的技術(shù)模式為TSSG法。
該方法可以在更低的溫度下(低于2000 ℃)實現(xiàn)SiC在近熱力學平衡狀態(tài)下生長,且生長的晶體具有質(zhì)量高、成本低、易擴徑、易實現(xiàn)穩(wěn)定的p型摻雜等優(yōu)勢,有望成為繼PVT法之后制備尺寸更大、結(jié)晶質(zhì)量更高且成本更低的SiC單晶的方法。
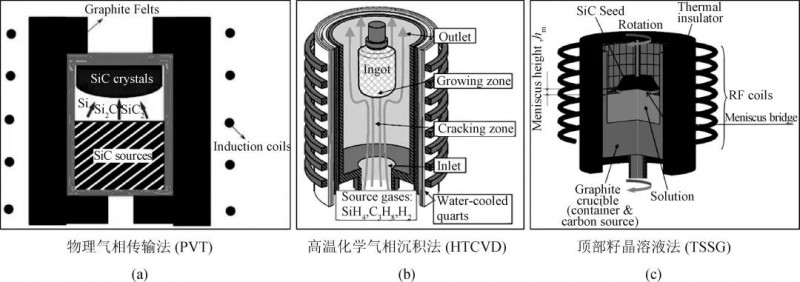
圖1 三種SiC單晶生長技術(shù)的原理示意圖
01 TSSG法長SiC單晶的發(fā)展歷程與現(xiàn)狀
HTSG法生長SiC已有60多年的發(fā)展歷史。
1961年,Halden等首次從溶解了C的高溫Si熔體中獲取了SiC單晶,隨后探索了從組成為Si+X的高溫溶液(其中X為Fe、Cr、Sc、Tb、Pr等元素的一種或幾種)中生長SiC單晶。
1999年,德國埃爾蘭根大學的Hofmann等以純Si為自助熔劑,利用高溫高壓的TSSG法,首次生長出直徑1.4英寸、厚度約1 mm的SiC單晶。
2000年,他們進一步優(yōu)化工藝,在100~200 bar的高壓Ar氣氛中,在1900~2400 ℃下,以純Si為自助熔劑生長出直徑20~30 mm、厚度可達20 mm的SiC晶體。
此后,日本、韓國、法國以及中國等國家的科研工作者先后開展TSSG法生長SiC單晶襯底的研究,使得TSSG法在近年來取得了較快發(fā)展。其中,日本以住友金屬和豐田公司為代表,表1和圖2示出日本住友金屬在SiC單晶生長方面的研究進展情況,表2和圖3則展示了豐田公司的主要研究歷程和代表性成果。
本研究團隊于2016年開始開展TSSG法生長SiC晶體的研究工作,成功地獲得了厚度為10 mm的2英寸4H-SiC晶體。近期團隊已成功生長出4英寸的4H-SiC晶體,如圖4所示。
表1 日本住友金屬相關(guān)團隊采用TSSG法生長SiC晶體的發(fā)展歷程

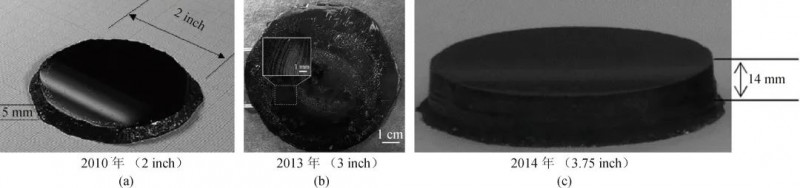
圖2 日本住友金屬相關(guān)團隊用TSSG法生長的SiC晶體的光學照片
表2 豐田公司相關(guān)團隊用TSSG法生長SiC單晶的發(fā)展歷程


圖3 豐田公司相關(guān)團隊用TSSG法生長SiC單晶的代表性成果
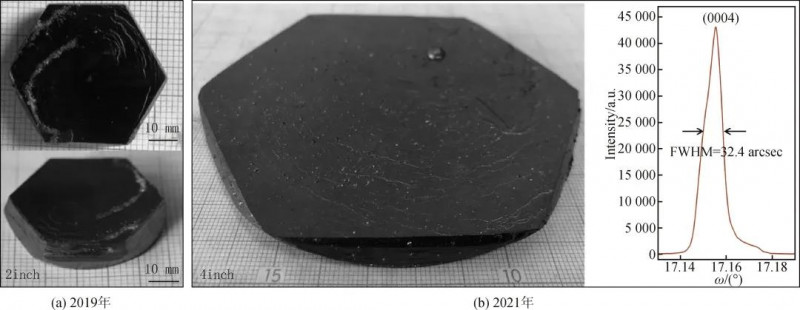
圖4 中國科學院物理研究所用TSSG法生長SiC單晶的代表性成果
02 TSSG法生長SiC單晶的基本原理
SiC在常壓下沒有熔點,當溫度達到2000 ℃以上會直接氣化分解,因此以同成分的SiC熔體緩慢冷卻凝固,即熔體法,來實現(xiàn)SiC單晶生長是不可行的。
根據(jù)Si-C二元相圖,在富Si端存在“L+SiC”的二相區(qū),這為SiC的液相法生長提供了可能。但是純Si對C的溶解度太低,因此需要在Si熔體中添加助熔劑來輔助提高高溫溶液中的C濃度。目前利用HTSG法生長SiC單晶的主流技術(shù)模式為TSSG法,圖5(a)為TSSG法生長SiC單晶的原理示意圖。
其中,對高溫溶液的熱力學性質(zhì)以及溶質(zhì)傳輸過程和晶體生長界面處的動力學的調(diào)控以使溶質(zhì)C在整個生長系統(tǒng)中實現(xiàn)良好的供需動態(tài)平衡,是更好地實現(xiàn)TSSG法生長SiC單晶的關(guān)鍵。
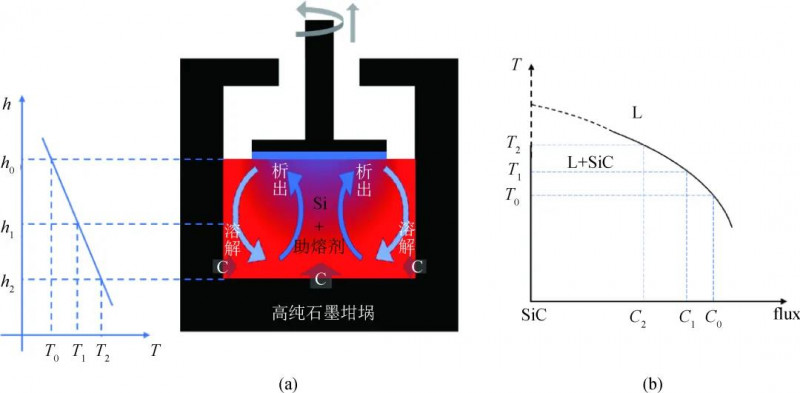
圖5:(a)TSSG法生長SiC單晶的示意圖;
(b)L+SiC二相區(qū)的縱截面示意圖
03 高溫溶液的熱力學性質(zhì)
將足夠的C溶解到高溫溶液中是實現(xiàn)TSSG法生長SiC單晶的關(guān)鍵,添加助熔劑元素是增加高溫溶液對C的溶解度的有效途徑。
同時,助熔劑元素添加也會對高溫溶液的密度、粘度、表面張力、凝固點等與晶體生長密切相關(guān)的熱力學參數(shù)有調(diào)控作用,從而直接影響晶體生長中的熱力學和動力學過程。因而,助熔劑元素的選取是實現(xiàn)TSSG法生長SiC單晶中最為關(guān)鍵的一步,是該領(lǐng)域的研究重點。
文獻報道較多的二元高溫溶液體系,常見的有Li-Si、Ti-Si、Cr-Si、Fe-Si、Sc-Si、Ni-Si和Co-Si等,其中Cr-Si、Ti-Si和Fe-Si二元體系以及Cr-Ce-Al-Si等多元體系發(fā)展較好,且獲得了較好的晶體生長結(jié)果。
圖6(a)是2020年日本東北大學的Kawanishi等總結(jié)的Cr-Si、Ti-Si和Fe-Si三種不同高溫溶液體系下SiC生長速率和溫度之間的關(guān)系。如圖6(b)則是Hyun等設(shè)計了組成配比為Si0.56Cr0.4M0.04(M = Sc、Ti、V、Cr、Mn、Fe、Co、Ni、Cu、Rh和Pd)的一系列高溫溶液體系中C的溶解度結(jié)果。

圖6:(a)使用不同高溫溶液體系時SiC單晶生長速率和溫度之間的關(guān)系;
(b)1800 ℃下組分為Si0.56Cr0.4M0.04的高溫溶液中C的溶解度(M = Al、Sc、Ti、V、Cr、Mn、Fe、Co、Ni、Cu、Rh和Pd)
04 生長動力學調(diào)控
為更好地獲得高質(zhì)量的SiC單晶,還需要調(diào)控晶體析出的動力學過程。因此,TSSG法生長SiC單晶的另一個研究重點是對高溫溶液中和晶體生長界面中的動力學過程的調(diào)控。
調(diào)控的主要手段有:籽晶和坩堝的旋轉(zhuǎn)與提拉工藝、生長系統(tǒng)中溫場的調(diào)控、坩堝結(jié)構(gòu)與尺寸的優(yōu)化以及外加磁場調(diào)控高溫溶液對流等,根本目的是對高溫溶液和晶體生長界面處的溫場、流場及溶質(zhì)濃度場進行調(diào)控,從而更好、更快地從高溫溶液中有序析出SiC,并長成高質(zhì)量的大尺寸單晶。
研究者嘗試了很多方法實現(xiàn)動力學調(diào)控,如:Kusunoki等在2006年報道的工作中采用的“坩堝加速旋轉(zhuǎn)技術(shù)”,Daikoku等開發(fā)的“凹面溶液生長技術(shù)”等。
Kusunoki等于2014年通過在坩堝內(nèi)添加石墨環(huán)結(jié)構(gòu)作為浸沒導(dǎo)向器(immersion guide,IG)來實現(xiàn)高溫溶液對流的調(diào)控,通過優(yōu)化石墨環(huán)的尺寸和位置可以在籽晶下方的高溫溶液中建立均勻向上的溶質(zhì)傳輸模式,從而使晶體生長速率和質(zhì)量均有所提升,見圖7。

圖7:(a)坩堝中高溫溶液流動和溫度分布的模擬結(jié)果;
(b)實驗裝置示意圖及結(jié)果匯總
05 TSSG法生長SiC單晶的優(yōu)勢
TSSG法在生長SiC單晶方面的優(yōu)勢體現(xiàn)在以下幾方面:
(1)高溫溶液法生長SiC單晶可以有效地修復(fù)籽晶中的微管和其他宏觀缺陷,從而提高晶體結(jié)晶質(zhì)量。1999年Hofmann等通過光學顯微鏡觀察并證明了TSSG法生長SiC單晶的過程中微管可以被有效覆蓋,如圖8所示。
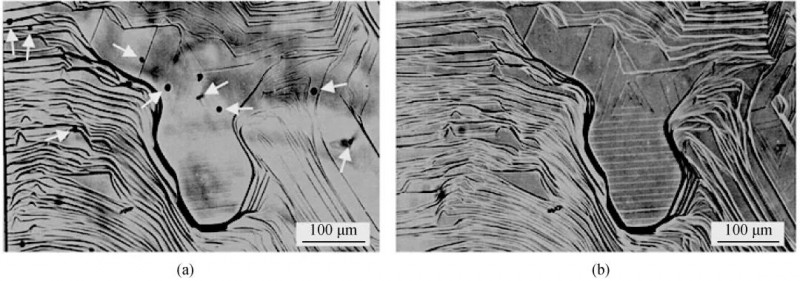
圖8:TSSG法生長SiC單晶過程中微管的消除:
(a)TSSG法生長后的SiC晶體在透射模式下的光學顯微照片,可以清楚地看到位于生長層下方的微管;
(b)相同區(qū)域在反射模式下的光學顯微照片,表明微管已經(jīng)被全部覆蓋
(2)相對于PVT法,TSSG法可以更容易地實現(xiàn)晶體的擴徑,從而增大SiC單晶襯底的直徑,有效提高SiC器件的生產(chǎn)效率并降低生產(chǎn)成本。
豐田公司和住友公司的相關(guān)研究團隊采用了一種“彎月面高度控制”的技術(shù)成功地實現(xiàn)了人為可調(diào)控的晶體擴徑,見圖9(a)和(b)。

圖9:(a)TSSG法中彎月面控制技術(shù)示意圖;
(b)生長角θ隨彎月面高度的變化圖及通過該技術(shù)獲得的SiC晶體的側(cè)視圖;
(c)彎月面高度為2.5 mm下生長20 h;
(d)彎月面高度為0.5 mm下生長10 h;
(e)生長35 h,彎月面高度從1.5 mm逐漸增大到更大的值
(3)相對于PVT法,TSSG法更容易對SiC晶體實現(xiàn)穩(wěn)定的p型摻雜。如豐田公司的Shirai等于2014年報道了其通過TSSG法生長的低電阻率p型4H-SiC晶體,見圖10。
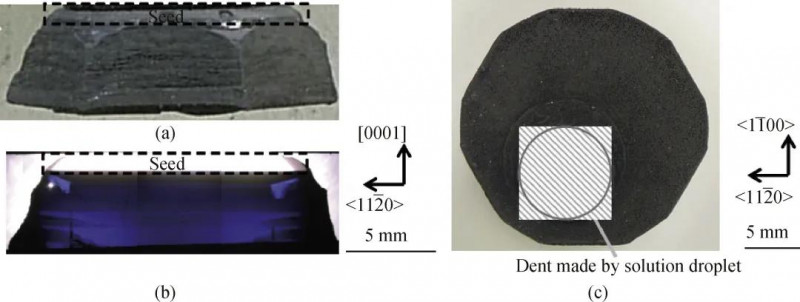
圖10:(a)TSSG法生長的p型SiC單晶的側(cè)視圖;
(b)晶體縱切片的透射光學照片;
(c)從Al含量為3%(原子數(shù)分數(shù))高溫溶液中生長的晶體的上表面形貌圖
06 結(jié)語與展望
TSSG法生長SiC單晶技術(shù)近20年來獲得了極大的發(fā)展,少數(shù)團隊已經(jīng)通過TSSG法生長出高質(zhì)量的4英寸SiC單晶。
然而,該技術(shù)的進一步發(fā)展還需要從以下幾個關(guān)鍵方面去重點突破:
(1)溶液熱力學性質(zhì)的深入研究;
(2)生長速率和結(jié)晶質(zhì)量的平衡;
(3)持穩(wěn)性晶體生長條件的建立;
(4)精細化動態(tài)調(diào)控技術(shù)的開發(fā)。
雖然TSSG法目前和PVT法相比還存在一定的差距,但相信在該領(lǐng)域研究工作者們的不斷努力下,隨著TSSG法生長SiC單晶核心科學問題的不斷解決和生長工藝中關(guān)鍵技術(shù)的持續(xù)突破,該技術(shù)也將實現(xiàn)產(chǎn)業(yè)化,從而充分發(fā)揮TSSG法生長SiC單晶技術(shù)的潛力,并進一步促進和推動SiC產(chǎn)業(yè)的快速發(fā)展。
