半導(dǎo)體產(chǎn)業(yè)網(wǎng)訊:近日,深圳大學(xué)材料學(xué)院劉新科研究員團(tuán)隊(duì)做出了自支撐GaN襯底上的高性能常關(guān)型PGaN柵極HEMT,用AlN截止層和SF6基刻蝕氣體做到了自終止刻蝕技術(shù)。對(duì)比Si基HEMT,GaN on GaN HEMT電流密度更高,低亞閾值擺幅更低,漏電流更低,靜態(tài)和動(dòng)態(tài)電阻更低,因?yàn)橥|(zhì)外延有更低的位錯(cuò)和缺陷。同時(shí),本次工作還測(cè)試了175℃高溫下Vth的穩(wěn)定性和均勻性。對(duì)比Si基HEMT 507V的擊穿電壓,GaN on GaN HEMT擊穿電壓可以達(dá)到683V,自支撐GaN襯底上的常關(guān)型AlGaN/GaN HEMT在功率器件應(yīng)用上展示出很大的潛力。
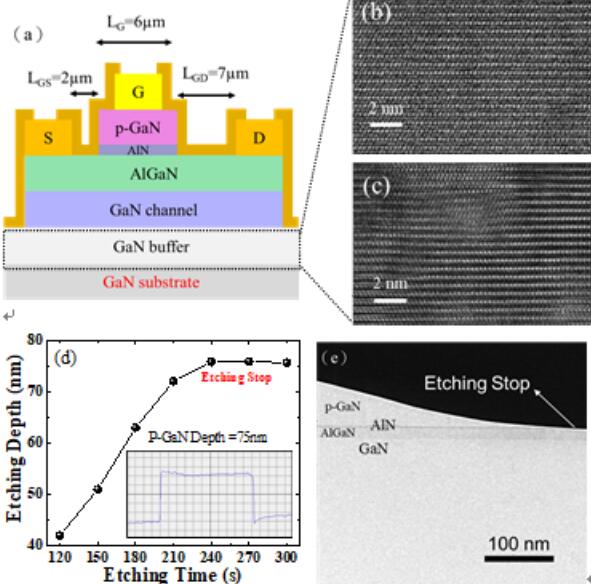

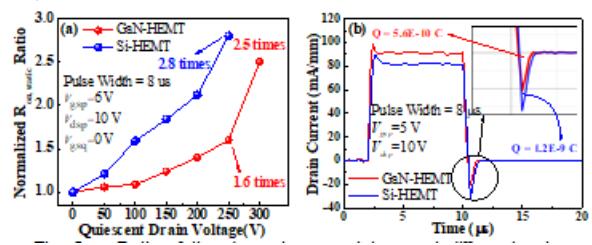
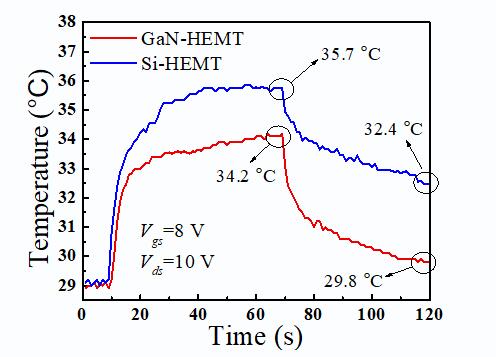
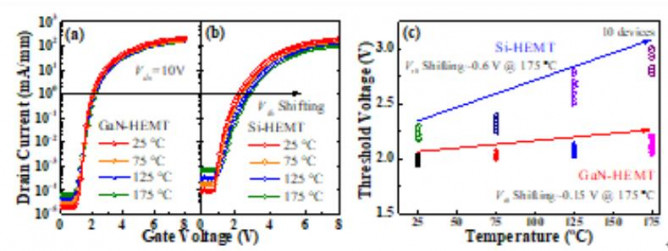
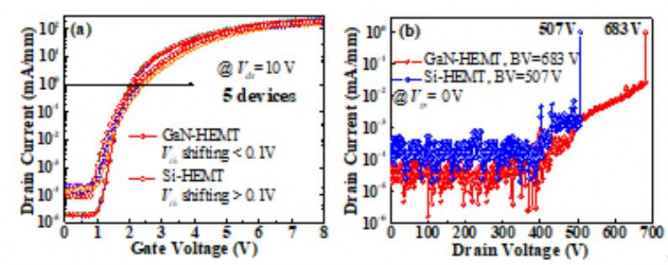
介紹
常斷操作AlGaN/GaN高電子遷移率晶體管(HEMTs)由于其固有的故障安全操作和簡(jiǎn)單的電路配置在實(shí)際應(yīng)用中受到了廣泛關(guān)注[1-4]。為了滿足實(shí)際應(yīng)用中3v及以上正閾值電壓(Vth)的要求,提出了許多方法,包括級(jí)聯(lián)結(jié)構(gòu)、凹柵結(jié)構(gòu)、氟離子處理、超薄勢(shì)壘(UTB)、p型帽層等[5-11]。其中,具有p-GaN柵極的GaN/GaN HEMTs已成功實(shí)現(xiàn)了商業(yè)化,并在實(shí)際應(yīng)用中表現(xiàn)出了優(yōu)越的性能。對(duì)于p-GaN柵HEMTs,制備過(guò)程中p-GaN非門(mén)控區(qū)蝕刻對(duì)器件行為至關(guān)重要,這與Vth的穩(wěn)定性和動(dòng)態(tài)特性有關(guān)[12-13]。因此,在電感耦合等離子體(ICP)干法刻蝕過(guò)程中需要精確的刻蝕。然而,過(guò)度蝕刻或過(guò)少蝕刻是不可避免的。為了解決這一問(wèn)題,提出了各種自端腐蝕方法來(lái)優(yōu)化腐蝕過(guò)程。
除了制造工藝,晶體質(zhì)量是AlGaN/GaN HEMTs的另一個(gè)問(wèn)題。出于生產(chǎn)和成本考慮,目前硅基板被廣泛用于生產(chǎn)氮化鎵電源器件。然而,Si襯底上應(yīng)變異質(zhì)外延生長(zhǎng)導(dǎo)致高密度的螺紋位錯(cuò)(約108-1010 cm-2),這將導(dǎo)致高功率工作[16]的可靠性和穩(wěn)定性問(wèn)題。對(duì)于GaN在Si上的外延生長(zhǎng),研究了多種生長(zhǎng)方法以提高GaN外延質(zhì)量,并將其作為晶圓的通道層或漂移層。提出了一種厚緩沖層來(lái)限制螺紋位錯(cuò)從晶圓底部到晶圓表面的擴(kuò)展[17-19]。然而,GaN與外源襯底之間存在著大量缺陷的過(guò)渡層,這可能是導(dǎo)致在高電壓水平[20]下過(guò)早擊穿的泄漏電流路徑。近年來(lái),大規(guī)模的GaN基板已經(jīng)商業(yè)化,并用于GaN基器件的同質(zhì)外延生長(zhǎng)。通過(guò)氫化物氣相外延(HVPE)生長(zhǎng)的獨(dú)立GaN體可以提供小于106 cm-2的螺紋位錯(cuò)密度,這顯示出進(jìn)一步提高GaN基器件性能[21]的希望。獨(dú)立GaN襯底的一個(gè)缺點(diǎn)是成本高,垂直GaN pnd的應(yīng)用范圍一直很窄。2英寸商業(yè)化GaN基板的成本為60-100美元/平方厘米。這個(gè)價(jià)格比4英寸SiC(約8美元/平方厘米)貴得多,比8英寸GaN-on-Si(約1美元/平方厘米)高得多[22,23]。因此,迄今為止,獨(dú)立式氮化鎵襯底的應(yīng)用主要集中在高終端市場(chǎng)。然而,隨著技術(shù)的發(fā)展和GaN材料的大規(guī)模應(yīng)用,高成本的獨(dú)立GaN襯底在不久的將來(lái)將會(huì)降低。
本文提出了一種基于獨(dú)立GaN襯底上的p-GaN/AlGaN/GaN異質(zhì)結(jié)構(gòu)hemt的高性能常斷裝置。同時(shí),還提出了一種具有相同外延結(jié)構(gòu)和制造工藝的Si- hemt,以進(jìn)行比較。首先,GaN-HEMT獲得了良好的外延質(zhì)量。然后,采用自端技術(shù),結(jié)合sf6基蝕刻氣體的p-GaN蝕刻過(guò)程在上層AlN層自動(dòng)停止,完成了GaN和Si-HEMT的柵極制備。該技術(shù)緩解了對(duì)AlGaN勢(shì)壘的過(guò)度或過(guò)少腐蝕。GaN-HEMT具有更先進(jìn)的電學(xué)性能,包括更高的電流密度、更低的次閾值擺動(dòng)(SS)、更低的動(dòng)態(tài)通電阻以及更好的Vth穩(wěn)定性和均勻性。GaN-HEMT生長(zhǎng)均勻,具有較好的散熱性能和較高的擊穿電壓(BV),這與低的位錯(cuò)和缺陷有關(guān)。因此,相對(duì)于Si-HEMT, GaN-HEMT在電力應(yīng)用領(lǐng)域顯示出巨大的潛力。
實(shí)驗(yàn)
器件結(jié)構(gòu)示意圖如圖1a所示。采用氫化物氣相外延法(HVPE)生長(zhǎng)了厚度為350 μ m、取向?yàn)?0001)的2英寸半絕緣摻鐵獨(dú)立GaN基板。鎵和氮源分別為HCl/金屬鎵和氨氣,N2/H2混合物為載氣。生長(zhǎng)速率通常在150 μ m/h左右。螺紋錯(cuò)位密度小于106 cm-2由零售商提供。本實(shí)驗(yàn)采用化學(xué)機(jī)械拋光(CMP)后,采用金屬有機(jī)化學(xué)氣相沉積(MOCVD)生長(zhǎng)法向關(guān)閉外延結(jié)構(gòu)。從下到上,外延結(jié)構(gòu)由GaN緩沖層、含有12 nm Al0.23Ga0.77N勢(shì)壘層和300 nm未摻雜GaN通道層的異質(zhì)結(jié)和75 nm Mg摻雜濃度為2×1019 cm-3的p型GaN層組成,以實(shí)現(xiàn)常關(guān)工作。同時(shí),將1.5 nm和1 nm的AlN分別作為蝕刻停止層和間隔層插入p-GaN/AlGaN和AlGaN/GaN的界面。外延層生長(zhǎng)完成后,在MOCVD室中進(jìn)行原位Mg活化過(guò)程,溫度為720℃,在N2環(huán)境中持續(xù)10分鐘?;魻枩y(cè)量得到孔濃度為1×1018 cm-3。利用透射電子顯微鏡(TEM)對(duì)GaN襯底外延堆的晶體質(zhì)量進(jìn)行了表征。由于GaN襯底位錯(cuò)密度較低,緩沖層的晶體質(zhì)量較好,如圖1b所示,這說(shuō)明GaN-on-GaN比GaN-on- si能獲得更高的外延質(zhì)量(圖1c)。
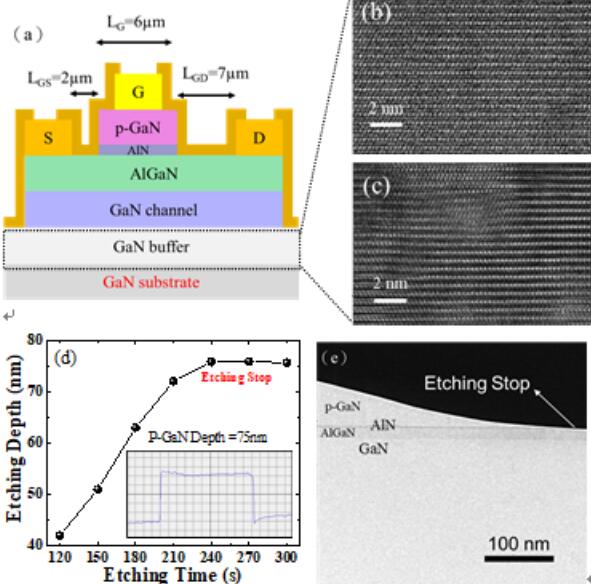
圖1所示。器件的截面圖(a)和GaN (b)和Si襯底上GaN緩沖層的TEM圖像(c)。P-GaN刻蝕深度隨刻蝕時(shí)間的函數(shù)(d)和刻蝕停止食譜的TEM圖像(e)。插入件為刻蝕過(guò)程后的刻蝕深度。相應(yīng)的尺寸也有標(biāo)記。
常規(guī)剝離GaN-HEMT的制備基于標(biāo)準(zhǔn)光刻和剝離技術(shù),從電感耦合等離子體(ICP)干法刻蝕的臺(tái)面隔離開(kāi)始。然后,使用Cl2/BCl3/SF6混合蝕刻氣體,通過(guò)ICP干法蝕刻去除接觸區(qū)p-GaN層。自終止過(guò)程發(fā)生,這歸因于sf6基蝕刻氣體與上面的1.5 nm AlN反應(yīng)形成的AlF3蝕刻停止層[24]。通過(guò)延長(zhǎng)ICP刻蝕時(shí)間,研究了刻蝕停止配方的公差。如圖1c所示,在240 s時(shí),刻蝕深度達(dá)到75 nm,說(shuō)明此時(shí)p-GaN層被移除。當(dāng)刻蝕時(shí)間達(dá)到300 s時(shí),刻蝕深度仍為75 nm,如圖1d所示。圖1e中去除p-GaN步驟后器件的TEM照片也表明,這種自端技術(shù)可以有效地保護(hù)AlGaN阻擋層免受過(guò)多或較少的蝕刻誤差。
經(jīng)H2SO4:H2O2=4:1 (SPM)和稀釋的HCl溶液清洗后,采用電子束蒸發(fā)法制備了Ti/Al/Ni/Au (25/120/25/150 nm)金屬疊加歐姆電極。歐姆接觸是通過(guò)在N2環(huán)境下,在875℃退火30s獲得的。最后,采用Ni/Au (25/120 nm)柵金屬層,沉積100 nm的SiO2作為鈍化層。GaN-HEMT的器件幾何結(jié)構(gòu)由指型柵(Wg為100 μm, Lg為6 μm)、指型柵(Lgs為2 μm, Lgd為7 μm)組成。在長(zhǎng)度為6 μm的柵極區(qū)域上,柵極金屬長(zhǎng)度為5 μm。p-GaN的邊緣與柵金屬邊緣之間有0.5 μm的空白。為了進(jìn)行比較,還提出了具有相同外延層和制作工藝的法向關(guān)閉Si-HEMT。GaN和Si-HEMT的片電阻分別為571和628 Ω/□,對(duì)應(yīng)的接觸歐姆電阻分別為8.1×10?6和9.6×10?6 Ω·cm2,轉(zhuǎn)移長(zhǎng)度法(TLM)提取。
結(jié)果與討論
半測(cè)井傳遞特征如圖2a所示。GaN-HEMT和Si-HEMT的閾值電壓(Vth定義為Id=1 mA/mm)分別為2和2.2 V,其次是163 mV/dec和217 mV/dec的次閾值波動(dòng)(SS)。與此同時(shí),GaN-HEMT的開(kāi)/關(guān)比為1.08×107,高于Si-HEMT的1.9×106。Si-HEMT較大的Vth可能與低開(kāi)/關(guān)比和高SS有關(guān)。Si-HEMT低開(kāi)/關(guān)比是由于位錯(cuò)導(dǎo)致的相對(duì)較高的脫態(tài)漏漏電流。即使研究了許多技術(shù)來(lái)提高Si襯底上的外延質(zhì)量,仍然存在大量的位錯(cuò),這通常是工作時(shí)泄漏電流的路徑。因此,推薦在GaN基板上均勻外延生長(zhǎng)。

圖2所示。GaN和Si-HEMT在Vds為10v時(shí)的傳輸特性(a)、跨導(dǎo)曲線(b)、輸出特性(c)和對(duì)數(shù)坐標(biāo)(d)下的柵極電流-電壓特性的半對(duì)數(shù)圖
此外,兩種器件的跨導(dǎo)曲線和最大值相似,如圖2b所示。當(dāng)GaN和Si-HEMT的柵電壓(Vg)從0掃至8 V時(shí),器件的輸出I-V特性如圖2c所示。具有良好的掐斷特性,無(wú)明顯的遲滯現(xiàn)象。GaN和Si-HEMT的最大電流密度在206和185 mA/mm左右,這決定了GaN- hemt的開(kāi)態(tài)電阻值為10.1 Ω?mm,而Si-HEMT的開(kāi)態(tài)電阻值為14.2 Ω?mm。通態(tài)電阻由歐姆電極的接觸電阻和通道電阻(包括接入?yún)^(qū)和柵區(qū))組成。因此,由于接觸電阻可以忽略,通道電阻貢獻(xiàn)了主要部分。此外,兩個(gè)器件具有相似的二維電子氣(2DEG)濃度,這是由相同的外延結(jié)構(gòu)產(chǎn)生的。因此,與Si-HEMT相比,GaN-HEMT的低通態(tài)電阻主要是由于均勻外延生長(zhǎng)的優(yōu)勢(shì)使缺陷密度更小,從而產(chǎn)生了更高的電子遷移率。另一方面,兩種hemt的柵漏電流也如圖2d所示。結(jié)果表明,GaN-HEMT在正向和反向偏置區(qū)域均具有較低的柵漏電流,且相對(duì)于Si-HEMT具有較大的柵擺幅。對(duì)于Si-HEMT,柵極擊穿發(fā)生在Vg約為8 V時(shí),而GaN-HEMT即使在10 V時(shí)也不會(huì)擊穿。
用脈沖Id-Vds測(cè)量了兩種HEMTs的動(dòng)態(tài)性能,包括動(dòng)態(tài)通阻和反向恢復(fù)行為。圖3a給出了不同靜漏偏置點(diǎn)下快速開(kāi)關(guān)動(dòng)態(tài)通阻與靜態(tài)通阻之比(Ron,動(dòng)態(tài)/Ron,靜態(tài))。實(shí)驗(yàn)條件為脈沖電壓(Vgsp, Vdsp)為(6,10),靜止電壓(Vgsq, Vdsq)為(0,0)~(0,300),脈沖寬度為8 μs,周期為200 μs。通常情況下,當(dāng)在器件上施加高的靜止漏極電壓時(shí),二維電子氣(2DEG)通道中的部分電子會(huì)外溢并被位于外延層的缺陷捕獲,這是由于外延生長(zhǎng)過(guò)程中的位錯(cuò)造成的。這可能會(huì)導(dǎo)致2℃濃度的降低,從而導(dǎo)致在快速開(kāi)關(guān)開(kāi)關(guān)設(shè)備時(shí),高的接通電阻和低的電流密度(電流崩壞現(xiàn)象)。如圖3a所示,GaN-HEMT的Ron,動(dòng)力在100v以下有緩慢的增加,比值曲線的斜率在100v到250v之間有一點(diǎn)上升。然而,GaN-HEMT仍然表現(xiàn)出相當(dāng)?shù)偷腞on的1.6倍,靜態(tài)相對(duì)于Si-HEMT的2.8倍,在250 V的靜漏電壓下。GaN-HEMT優(yōu)良的動(dòng)態(tài)通電阻主要是由于缺陷捕獲的電子較少,從而抑制了電流塌縮。這說(shuō)明GaN的同質(zhì)外延結(jié)構(gòu)可以提高外延質(zhì)量,同時(shí)大幅度降低缺陷捕獲電子的大小。但GaN-HEMT的Ron,動(dòng)態(tài)在300v時(shí)急劇升高,表明GaN-HEMT的有效鈍化和最佳生長(zhǎng)條件有待進(jìn)一步研究。
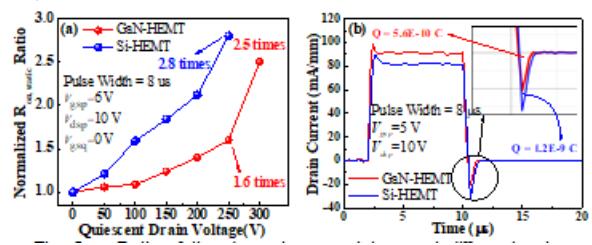
圖3所示。GaN和Si-HEMT在不同靜漏偏置點(diǎn)的動(dòng)態(tài)通阻比(a)和動(dòng)態(tài)恢復(fù)行為(b)。
另一方面,當(dāng)脈沖電壓(Vgsp, Vdsp)為(5,10),脈寬為8 μs時(shí),動(dòng)態(tài)恢復(fù)行為如圖3b所示。盡管GaN-HEMT具有較高的漏極電流密度,但反向電流密度較低,恢復(fù)時(shí)間較短,這是由于GaN-HEMT具有如圖3b所示的低存儲(chǔ)電荷。儲(chǔ)能效應(yīng)主要由截留載波在關(guān)斷時(shí)刻放電產(chǎn)生,并導(dǎo)致反向恢復(fù)電流。由于緩沖層和襯底作為捕獲中心的外延缺陷較少,gan - hemt具有較好的反向性能。這也是Si-HEMT反向性能較差的原因。
為了研究器件的散熱性能,采用微拉曼光譜紅外熱像儀對(duì)器件的溫度進(jìn)行了測(cè)量。測(cè)量過(guò)程是先在8 V Vgs和10 V Vds下工作60 s,然后冷卻50 s。熱導(dǎo)率隨時(shí)間變化的曲線如圖4所示。當(dāng)進(jìn)行該裝置時(shí),柵極區(qū)域的溫度迅速上升到一個(gè)較高的水平。隨著操作時(shí)間的延長(zhǎng),溫度繼續(xù)呈梯度上升。GaN和Si-HEMT的最高溫度分別為34.2和35.7℃,其中GaN- hemt的低溫度部分歸因于低通電阻。冷卻50 s后,GaN-HEMT的柵極溫度降至29.8℃。相反,Si-HEMT的積熱去除緩慢,50 s后達(dá)到34.2℃。顯然,與Si- hemt相比,GaN- hemt具有更好的散熱性能,盡管Si和GaN的導(dǎo)熱系數(shù)相近[21]。主要原因是兩種材料的界面處普遍存在較大的熱邊界阻力,導(dǎo)致熱不能立即傳導(dǎo)[25]。因此,GaN基板上的均勻生長(zhǎng)有利于GaN電源器件的熱管理。
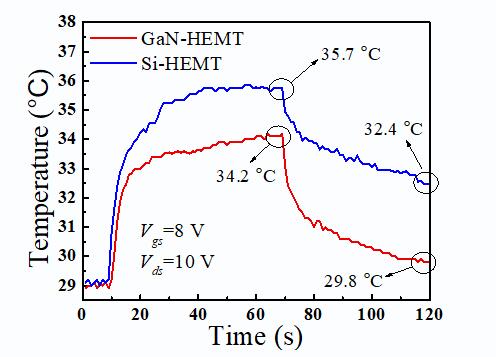
圖4所示。熱導(dǎo)率曲線隨時(shí)間變化,設(shè)備運(yùn)行60 s,冷卻50 s。
為了研究GaN和Si-HEMT的熱穩(wěn)定性,我們測(cè)量了從室溫(25℃)到175℃的傳遞特性,步長(zhǎng)為50℃(圖5a和b)。對(duì)于具有明顯v值漂移的Si-HEMT, GaN- hemt的傳遞曲線幾乎重合。為了更通用,在兩個(gè)晶片中隨機(jī)選擇10個(gè)器件進(jìn)行測(cè)量并計(jì)算平均第v移值。GaN-HEMT表現(xiàn)出良好的穩(wěn)定性,第V位移約為0.15 V至175℃,而Si-HEMT的第V位移為0.6 V(圖5c和d)。
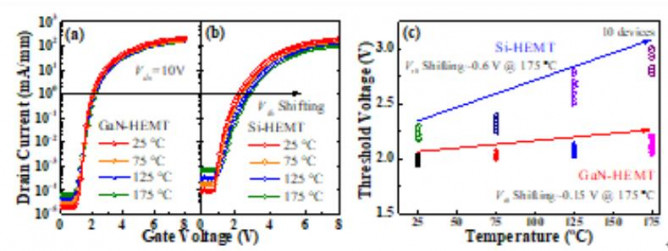
圖5所示。25 ~ 175℃(a)和(b)的傳遞特性的半對(duì)數(shù)和Vth穩(wěn)定性取決于溫度(c)。
在漏極電壓為10 V時(shí),研究了圖6a中5個(gè)器件的Vth均勻性。GaN-HEMT的離態(tài)泄漏電流較低,為10- 5ma /mm,第V次位移小于0.1 V,均優(yōu)于Si-HEMT。然后,測(cè)量脫態(tài)擊穿電壓,Vgs為0v, Vds從0掃至圖6b所示的擊穿電壓。GaN和Si-HEMT的擊穿電壓分別為683和507 V,這是由漏極電流達(dá)到1 mA/mm定義的。同時(shí)GaN-HEMT具有較低的漏電流。這說(shuō)明GaN-HEMT比Si-HEMT具有更好的離態(tài)性能。對(duì)于動(dòng)態(tài)通阻測(cè)量,關(guān)閉裝置并采用高漏壓。該偏壓條件與擊穿測(cè)量的偏壓條件相似,但漏極電壓遠(yuǎn)小于器件的擊穿電壓。對(duì)于第二階段,用相對(duì)較小的漏極電壓打開(kāi)器件,以計(jì)算通阻。通常,動(dòng)態(tài)電阻問(wèn)題是由晶體缺陷在阻擋層和緩沖層中的電子俘獲效應(yīng)引起的。當(dāng)來(lái)自2DEG通道的電子在脫態(tài)時(shí)被缺陷捕獲,導(dǎo)通能力降低,導(dǎo)致通阻增加。較高的缺陷密度可能與更嚴(yán)重的動(dòng)態(tài)電阻問(wèn)題有關(guān)。另一方面,這些缺陷也會(huì)在器件中提供漏電通路,影響擊穿電壓。由以上討論可知,動(dòng)態(tài)導(dǎo)通電阻和擊穿電壓都與晶體質(zhì)量有一定的關(guān)系。
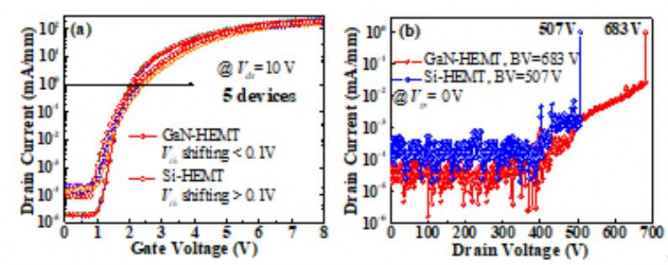
圖6所示。GaN和Si-HEMT的Vth均勻性(a)和脫態(tài)擊穿電壓(b)。
為了進(jìn)一步提高離態(tài)擊穿性能,首選采用場(chǎng)板(FP)終端設(shè)計(jì)。FP作為一種相對(duì)簡(jiǎn)單的邊緣終端,廣泛應(yīng)用于gan基器件中,用于緩解漏側(cè)柵邊電場(chǎng)擁擠。因此,結(jié)合FP終端和獨(dú)立的GaN襯底,該e型器件的性能將是值得研究的。
總結(jié):綜上所述,深圳大學(xué)劉新科研究員團(tuán)隊(duì)在獨(dú)立的GaN基板上制備了具有p-GaN柵極的常關(guān)AlGaN/GaN高電子遷移率晶體管(HEMT)。為了去除p-GaN,同時(shí)減小蝕刻誤差,采用sf6基蝕刻氣體自端蝕刻技術(shù)。GaN- hemt在GaN基板上具有良好的外延性能,表現(xiàn)出比Si-HEMT更先進(jìn)的電學(xué)性能,包括更高的電流密度、更低的亞閾值擺動(dòng)(SS)、更低的動(dòng)態(tài)通電阻以及更好的Vth穩(wěn)定性和均勻性。同時(shí),由于同質(zhì)性GaN-HEMT具有良好的生長(zhǎng)、良好的散熱和較高的擊穿電壓(BV),這是由于低的位錯(cuò)和缺陷。因此,GaN-HEMT具有優(yōu)異的電性能和熱性能,在電力應(yīng)用領(lǐng)域顯示出巨大的潛力。
原文: High-Performance_Normally-Off_Operation_p-GaN_Gate_HEMT_on_Free-Standing_GaN_Substrate.pdf
High-Performance_Normally-Off_Operation_p-GaN_Gate_HEMT_on_Free-Standing_GaN_Substrate.pdf
原文:
